2. 上海电机学院电气工程学院, 上海, 201306
2. College of Electrical Engineering, Shanghai Dian Ji University, Shanghai, 201306, China
与硅(Si)功率器件相比,碳化硅(Silicon carbide, SiC)功率器件具有更优电气特性和热特性[1],可大幅提高电力电子变换器的性能,在工业[2-4]、高温高频[5-9] 和可再生能源发电[10]等诸多场合中已获得初步应用。随着SiC工艺技术的日趋成熟,SiC功率器件有望取代传统的Si功率器件,在未来的电力电子变换器中获得更为广泛的应用与发展。目前,SiC MOSFET是商业化程度最高的SiC可控功率器件。但是,由于SiC MOSFET管芯面积小, 电流密度大[11]且短路能力较弱,因此对电路保护要求更高,给SiC基电力电子变换器的可靠性带来极大挑战,特别是在大功率场合,这一问题更加突出。因此,SiC MOSFET短路特性及其稳健性逐渐受到研究人员的关注,成为SiC MOSFET重要研究内容之一。
近些年,国内外诸多学者针对SiC功率器件的短路特性进行了研究。文献[12]对SiC MOSFET的短路稳健性进行了研究,得出400 V直流母线电压下SiC MOSFET短路承受时间约为30 μs。文献[13]在600 V直流母线电压下分别对相同电压定额的两种SiC MOSFET的短路稳健性进行了研究,得出两者的短路承受时间分别为5 μs和14 μs。文献[14]对不同直流母线电压下Si和SiC MOSFET的短路特性进行了对比和研究。但是,这些研究只针对不同直流母线电压的SiC MOSFET短路特性进行了研究,忽略了驱动回路参数的影响。另外,这些研究大多只是对实验现象的定性描述,缺乏进一步深入分析。因此,本文首先对SiC MOSFET短路机理进行了分析,在此基础上对不同电路参数对其短路特性的影响进行了对比和研究,揭示了短路特性的关键影响因素,并对器件短路能力及恶化机理进行了对比分析,为研究人员设计SiC MOSFET短路保护提供了一定的指导。
1 短路故障类型及测试电路功率器件的短路故障类型可分为硬开关故障(Hard switching fault, HSF)和负载故障(Fault under load, FUL)。硬开关故障是指在开关管开通时发生短路故障,即在开关管开通之前,负载已经短路,电源电压直接加在开关管两端。当开关管开通时,就会在电路中形成一个低阻抗回路,导致流过开关管的电流急剧上升。而负载故障是指在开关管完全导通时发生短路故障,即在发生短路故障之前,开关管导通,电路处于正常工作状态。当负载突然短路时,就会在电路中形成一个低阻抗回路,导致回路电流急剧上升。由于硬开关故障下,SiC MOSFET功率损耗更大,发热更严重,对器件的考验更为严峻,所以本文对SiC MOSFET的硬开关故障进行了原理分析。
图 1为硬开关故障模式下SiC MOSFET短路特性测试原理图。UDC 为可调直流电源,Rin为电源内阻,CB为断路器,UG为单脉冲驱动信号,Rg为驱动电阻,Cgs ,Cgd和Cds为SiC MOSFET的寄生电容,Lg,Ld和Ls分别为包括器件外部引线和器件内部连线的栅极、漏极和源极的寄生电感。

|
图 1 硬开关故障下短路测试原理图 Figure 1 Schematic of short-circuit test circuit for hard-switching fault |
2 SiC MOSFET短路原理分析
硬开关故障下SiC MOSFET短路原理波形如图 2所示,可以分为4个工作模态。

|
图 2 硬开关故障下SiC MOSFET短路理论波形 Figure 2 Short-circuit waveforms of SiC MOSFET for hard-switching fault |
模态1[t1~t2]:t1时刻之前,SiC MOSFET处于截止状态。此时,断路器CB闭合,直流母线电压UDC直接加在SiC MOSFET两端。t1时刻,SiC MOSFET开通。由于功率回路阻抗很小,SiC MOSFET漏极电流急剧增大。同时,短路电流变化率di/dt作用于回路寄生电感Lloop(Lloop=Ld+Ls),在Lloop上产生一个与直流母线电压极性相反的电压ULloop,导致SiC MOSFET漏源极电压有所下降。ULloop可表示为
| $ {U_{{\rm{Lloop}}}}={L_{{\rm{loop}}}} \times \frac{{{\rm{d}}\mathit{i}}}{{{\rm{d}}\mathit{t}}} $ | (1) |
则SiC MOSFET两端的电压Uds为
| $ {U_{{\rm{ds}}}} = {U_{{\rm{DC}}}}-{U_{{\rm{Lloop}}}} $ | (2) |
在短路电流上升过程中,SiC MOSFET的功率损耗导致自发热,SiC MOSFET结温逐渐升高,导通电阻也随之逐渐增大,导致di/dt逐渐减小,这是因为在短路回路中SiC MOSFET导通之后,导通电阻、寄生电感组成了一个一阶LR串联电路,随着导通电阻的增大,回路阻抗增大,电流上升速率有所降低,SiC MOSFET漏源极Uds又逐渐升高。t1~t2阶段内,SiC MOSFET沟道载流子迁移率具有正温度系数,故短路电流一直增大。但SiC MOSFET自身功率损耗很大,导致自发热,开关管结温快速升高。
模态2[t2~t3]:随着SiC MOSFET结温的升高,t2时刻SiC MOSFET沟道载流子迁移率开始降低,导致流过开关管的电流减小,di/dt为负。
在这一阶段,SiC MOSFET沟道载流子迁移率具有负温度系数,可表示为
| $ {\mu _{\rm{p}}}(\mathit{T}) = {\mu _{{\rm{p0}}}}{\left( {\frac{T}{{300}}} \right)^{-2.2}}\;\;\;{\mu _{\rm{n}}}(\mathit{T}) = {\mu _{{\rm{n0}}}}{\left( {\frac{T}{{300}}} \right)^{-2.6}} $ | (3) |
式中:μp为4H-SiC外延层空穴迁移率,μn为4H-SiC外延层电子迁移率,μp0为T=300 K时空穴迁移率,μn0为T=300 K时电子迁移率。
模态3[t3~t4]:随着结温的进一步升高,t3时刻,SiC MOSFET沟道载流子电流减小的速率小于热电离激发漏电流增大的速率,短路电流又逐渐变大,di/dt为正。
t1~t4的短路能量EC可表示为
| $ {E_C} = \int_{{t_1}}^{{t_4}} {{U_{{\rm{ds}}}}{\mathit{i}_{\rm{d}}}{\rm{d}}\mathit{t}} $ | (4) |
式中:Uds为MOSFET漏源极电压,id为漏极电流。
模态4[t4~]:t4时刻开关管关断,开关管端电压出现关断过压,电流逐渐减小到零,此后会出现两种情况:(a)开关管安全可靠关断;(b)开关管栅极氧化层击穿,器件失控。
3 电路参数对短路特性的影响影响SiC MOSFET短路特性的因素包括栅极驱动电路参数和直流母线电压。为了量化分析各电路参数对SiC MOSFET短路特性的影响,制作了短路测试平台,如图 3所示。待测SiC MOSFET采用ROHM公司的SCH2080KE,其定额为1 200 V/35 A。测试中直流电源采用Chroma公司62150H-600型可编程稳压直流电源。功率器件的电压和电流波形通过Tektronix公司的高压差分探头(P5201)、高频电流探头(TCP303)和电流探头放大器(TCPA300)测得。实验测试条件为:寄生电感L=0.18 μH,SiC MOSFET驱动电路负向驱动电压设定为-2 V。
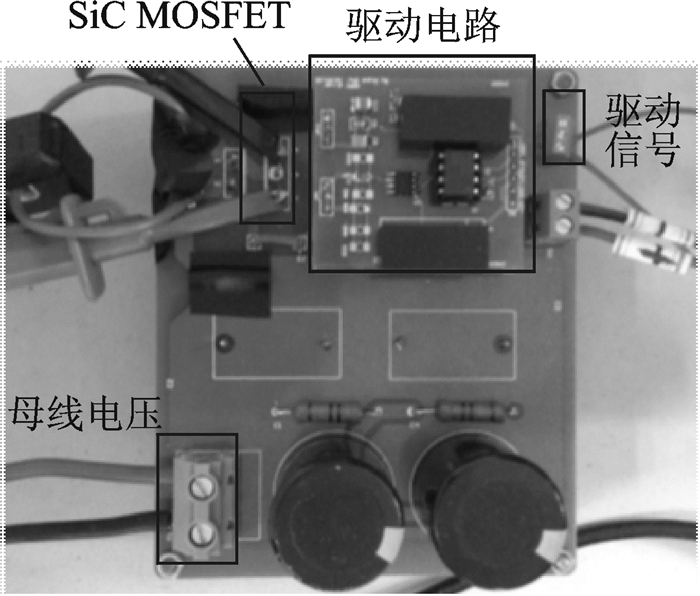
|
图 3 短路测试电路样机 Figure 3 Prototype of short-circuit test circuit |
3.1 直流母线电压的影响
图 4给出不同直流母线电压UDC下,栅源极电压Ugs,漏源极电压Uds和漏极电流id的短路测试波形。直流母线电压升高,短路电流上升速度更快,短路峰值电流也逐渐增大,同时栅源极电压Ugs下降时间变长,关断过压变化幅度较小。测试中短路脉宽设定为5 μs,此时SiC MOSFET管芯内部结温并不高,沟道载流子迁移率具有正温度系数,di/dt为正,短路电流一直增大。
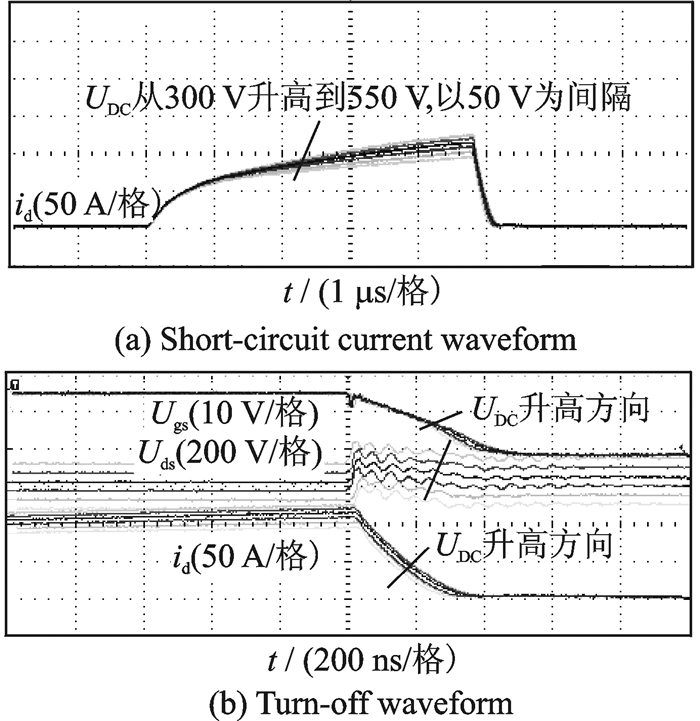
|
图 4 不同直流母线电压UDC下的Ugs, Uds和id短路测试波形 Figure 4 Short-circuit waveforms of Ugs, Uds and id under different DC bus voltages |
3.2 驱动电阻的影响
直流母线电压为550V,驱动电阻Rg分别取30,20,10和5 Ω。图 5给出不同驱动电阻下,栅源极电压Ugs, 漏源极电压Uds和漏极电流id的短路测试波形。随着驱动电阻的减小,SiC MOSFET关断速度更快,漏源极电压和栅源极电压的振荡略有增大,而短路电流波形几乎没有变化,不同驱动电阻下的短路峰值电流保持不变,这是因为驱动电阻主要影响短路电流初期的上升速度,驱动电阻减小会加快短路电流初期的上升速度,但对短路电流波形和短路峰值电流几乎没有影响。
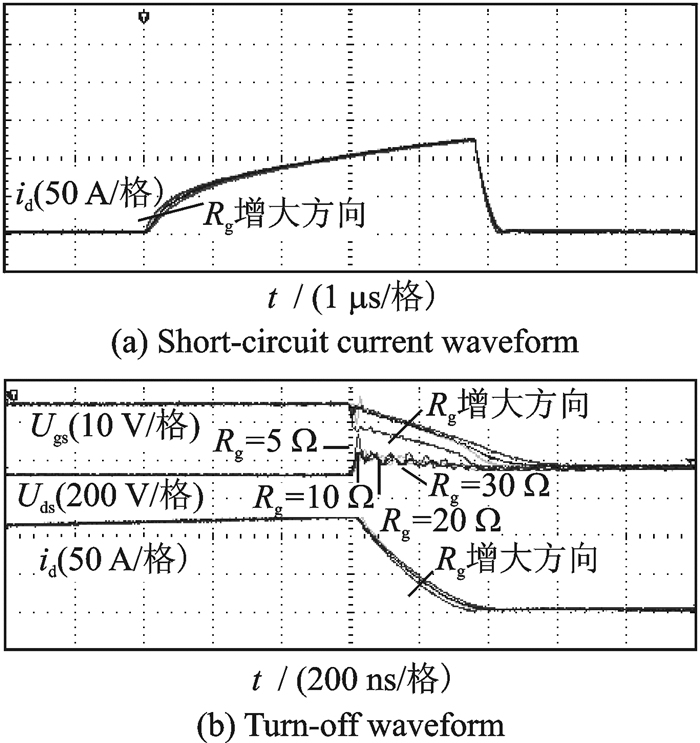
|
图 5 不同驱动电阻Rg下的Ugs, Uds和id短路测试波形 Figure 5 Short-circuit waveforms of Ugs, Uds and id under different gate resistances |
3.3 栅极驱动电压的影响
直流母线电压为550 V,驱动电阻为30 Ω,由于SCH2080KE型SiC MOSFET栅极正向电压极限值为+22 V,考虑一定的安全裕量,驱动电压分别取+20, +18和+15 V。图 6给出不同栅极驱动电压下,栅源极电压Ugs, 漏源极电压Uds和漏极电流id的短路测试波形。由图 6可见,栅极驱动电压对SiC MOSFET短路电流影响比较明显。SiC MOSFET开通瞬间,随着栅极驱动电压的升高,短路电流上升速度越快,短路峰值电流越大。当栅极驱动电压为+20V时,短路电流达到峰值后开始逐渐减小,即di/dt开始为负,这是由于短路峰值增大导致功率管损耗大大增加,SiC MOSFET内部结温进一步升高使沟道载流子迁移率降低。
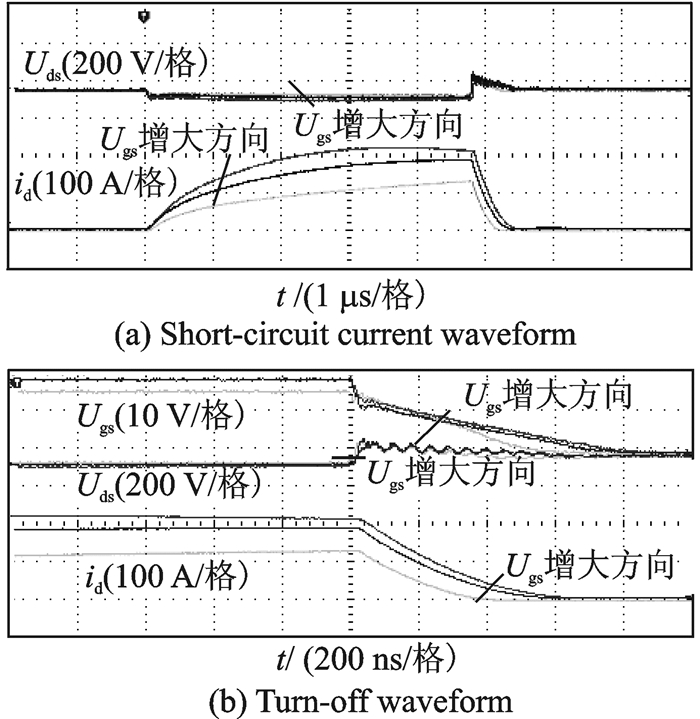
|
图 6 不同栅极驱动电压下的Ugs, Uds和id短路测试波形 Figure 6 Short-circuit waveforms of Ugs, Uds and id under different gate voltages |
3.4 电路参数影响的量化分析
为了进一步明确电路参数对短路特性的影响程度,对各电路参数与关断过压、短路峰值电流及短路能量的影响进行了量化分析。
(1) 对关断过压的影响
图 7给出关断过压ΔUds与各电路参数的关系曲线。直流母线电压升高,关断过压变化幅度较小,约为20 V。驱动电阻越小,关断速度越快,di/dt在回路寄生电感上产生的电压越高,即关断过压越大,且驱动电阻Rg为5 Ω时,关断过压约是Rg为30 Ω时关断过压的2倍。栅极驱动电压越高(低于20 V),短路电流越大,关断过压越大。由于栅极驱动电压的增大,SiC MOSFET沟道电阻减小,导致了短路电流峰值的增大。关断过压的增大是由于关断过程中di/dt的增大,与回路中寄生电感相互作用引起的感应电压增大。当栅极驱动电压达到20 V时,关断过压减小,这是由于短路损耗增大,器件结温大大升高,SiC MOSFET沟道载流子迁移率减低,导致短路电流减小。同时,由于此时器件内部结温较高,SiC MOSFET开启电压降低,关断速度降低,所以过压减小。

|
图 7 关断过压ΔUds与各电路参数的关系曲线 Figure 7 Relation curves of voltage o vershoot versus circuit parameters |
(2) 对短路峰值电流的影响
图 8给出短路峰值电流id(peak)与各电路参数的关系曲线。短路峰值电流与直流母线电压正相关,驱动电阻对短路峰值电流几乎没有影响,但栅极驱动电压对短路峰值电流影响较大且电压越高,峰值电流越大,栅极驱动电压Ugs为20 V时,短路峰值电流约为Ugs为15 V时的2倍。此外,当栅极驱动电压较低时(如15 V),短路峰值电流与直流母线电压近似为线性关系,变化幅度较大。而当栅极驱动电压较高时(如20 V),随着直流母线电压升高,短路峰值电流增长幅度趋于平缓。

|
图 8 短路峰值电流id(peak)与各电路参数的关系曲线 Figure 8 Relation curves of curre nt peak versus circuit parameters |
(3) 对短路能量的影响
图 9给出了短路能量Ec与各电路参数的关系图。显然,随着母线电压的升高,短路能量不断增大。而驱动电阻减小,短路能量略有增大。另外,由前述分析可知,栅极驱动电压对关断过压、短路峰值电流有很大的影响,故短路能量对栅极驱动电压较为敏感。栅极驱动电压Ugs为20 V时,短路能量是Ugs为15 V时的2倍左右。

|
图 9 短路能量损耗与各电路参数关系图 Figure 9 Relation graphs of short-circuit energy vers us circuit parameters |
由以上分析比较可知,栅极驱动电阻Rg对关断过压影响较大,而对短路峰值电流几乎没有影响;直流母线电压对短路峰值电流的影响较大,栅极驱动电压Ugs对关断过压和短路峰值电流的影响均较大。在设计短路保护电路时,往往采用“软关断”技术,即增大关断时的驱动电阻以降低开关管的关断速度,达到降低开关管电压应力的目的,但该方法并不能降低开关管的电流应力。另外,相比于栅极驱动电阻Rg,栅极驱动电压Ugs对关断过压和短路峰值电流的影响更为显著,若设计保护电路时采用“多电平关断”,既可以有效降低开关管的电压应力,又能大大减小开关管的短路电流应力,确保开关管可靠关断,但该方法增大了保护电路设计的复杂性。
4 短路能力及器件恶化分析 4.1 短路能力为探究MOSFET的短路能力,分别对1 200 V SiC MOSFET(SCH2080KE)和Si MOSFET(IXFH12N1 20P)在不同脉宽下的短路特性进行了测试,测试波形如图 10所示。
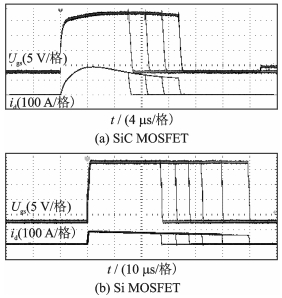
|
图 10 不同脉宽下SiC & Si MOSFET短路特性测试波形 Figure 10 Short-c ircuit waveforms of Ugs and id under dif ferent short-circuit pluse width |
短路脉宽初始值设置为10 μs,可以看出,短路电流先增大后减小,与前述分析一致。随着短路脉宽的进一步增大,关断时短路电流逐渐减小,但短路能量逐渐增大。当短路脉宽增大至15 μs时,SiC MOSFET通态时的栅源极电压Ugs已略有下降,说明此时栅极漏电流增大,器件性能开始恶化;当短路脉宽进一步增大至17.5 μs时,其通态时的栅源极电压Ugs下降幅度已增大至2 V,同时在SiC MOSFET关断后,经12 μs延时,栅源极电压Ugs变为0 V,SiC MOSFET栅源极已经短路,器件损坏,此时应对的短路能量Ec为1.365 J。而与之对应的Si MOSFET,在短路脉宽为17.5 μs时,器件依然保持良好的性能,即使脉宽增大至60 μs(短路能量Ec为2.403 J)仍能有效地断开短路电流,同时栅源极未被击穿。
4.2 器件恶化分析表 1给出正常和损坏的SiC MOSFET各端子阻抗及体二极管正向压降测试数据。可见,母线电压为550 V,短路脉宽为17.5 μs时,SiC MOSFET栅源极氧化层被击穿,栅源极近似短路,此时SiC MOSFET为不可控器件,但是其漏源极阻抗依然很大,具有一定的阻断能力,同时体二极管正向压降几乎保持不变。
| 表 1 SiC MOSFET各端子阻抗及体二极管正向压降测试数据 Table 1 Test data of terminal impedance and forward voltage of body diode drop for SiC MOSFET |
短路时,直流母线电压UDC直接加在MOSFET两端,由于MOSFET栅源极电压一般只有十几伏,故直流母线电压由反向偏置的PN结(漏源极寄生电容Cds)和MOS电容(栅漏极寄生电容Cgd)共同承担,图 11给出功率MOSFET内部电场强度分布图。
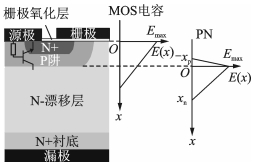
|
图 11 功率MOSFET内部电场强度分布图 Figure 11 Internal electric field distribution of power MOSFET |
由高斯定理可知,栅极氧化层中电场强度与其下方半导体材料电场强度满足
| $ {E_{{\rm{oxide}}}} = \frac{{{\varepsilon _{{\rm{semi}}}}}}{{{\varepsilon _{{\rm{oxide}}}}}}{E_{{\rm{max}}}} $ | (4) |
式中:εsemi为半导体的介电常数,εoxide为氧化层的介电常数。
对于SiC/SiO2(或Si/SiO2),εsemi/εoxide≈2.5,这意味着氧化层中电场强度是半导体中最大电场强度的2.5倍。SiO2的击穿场强为10 MV/cm,为保证氧化层的长期稳定性,氧化层中电场强度一般应小于4 MV/cm。对于Si MOSFET,由于Si的临界场强为0.3 MV/cm,因此氧化层中的电场强度最大为0.75 MV/cm,远小于4 MV/cm。但对于SiC MOSFET,由于SiC的临界场强更高,其内部最大电场强度可达Si MOSFET的十几倍,使氧化层中电场强度很容易超过4 MV/cm,不利于氧化层的长期稳定。同时,为获得期望的阈值电压,SiC MOSFET栅极氧化层厚度设计得更薄,势垒宽度更窄,根据Fowler-Nordheim沟道理论,当栅源极施加正向偏置电压时,反型层表面的电子会进入或穿过氧化层,进而产生沟道电流,即栅极漏电流。短路时,器件内部结温迅速升高使栅极漏电流大大增大。当该漏电流达到一定值就会导致氧化层电介质击穿,产生界面缺陷,最终导致器件恶化。
5 结论本文对SiC MOSFET的短路特性进行了研究,将不同电路参数对短路特性的影响进行了对比分析,并对功率MOSFET短路能力及器件恶化机理进行了研究,得出以下结论:(1)栅极驱动电阻Rg对短路峰值电流和短路能量影响很小,而对关断过压影响较大。(2)直流母线电压对短路峰值电流和短路能量变化影响较大,而关断过压变化影响较小,约为20 V。(3)栅极驱动电压对SiC MOSFET短路特性的影响最为显著。栅极驱动电压Ugs由15 V增大至20 V,SiC MOSFET短路峰值电流和短路能量约增大了两倍。设计短路保护电路时,为关断SiC MOSFET可适当降低栅极电平,这有益于SiC MOSFET安全关断,提高电路的可靠性。(4)由于SiC MOSFET阈值电压的要求及SiC材料的特殊性,SiC MOSFET的栅极稳定性更差,短路能力更弱。虽然随着工艺的进步,SiC MOSFET栅极氧化层稳定性有所提高,但快速有效的保护无疑是确保SiC MOSFET安全工作的最佳办法。
| [1] |
MILLÁ N J, GODIGNON P, PERPIÁ X, et al.
A survey of wide bandgap power semiconductor devices[J]. IEEE Transactions on Power Electronics, 2014, 29(5): 2155–2163.
DOI:10.1109/TPEL.2013.2268900
|
| [2] |
ZHANG Zheyu, WANG F, TOLBERT L M, et al.
Evaluation of switching performance of SiC devices in PWM inverterfed induction motor drives[J]. IEEE Transactions on Power Electronics, 2015, 30(10): 5701–5711.
DOI:10.1109/TPEL.2014.2375827
|
| [3] |
FRIEDRICHS P. SiC power devices for industrial applications[C]//International Power Electronics Conference. Sapporo, Japan: IEEE, 2010: 3241-3248. |
| [4] |
曹剑坤, 杨彬彬, 刘海春, 等.
集中式飞机外部供电架构及关键参数分析[J]. 南京航空航天大学学报, 2016, 48(1): 114–121.
CAO Jiankun, YANG Binbin, LIU Haichun, et al. Structure and key parameters of centralized ground power supply for aircraft[J]. Journal of Nanjing University of Aeronautics & Astronautics, 2016, 48(1): 114–121. |
| [5] |
ALEXANDRU M, BANU V, JORDÁ X, et al.
SiC integrated circuit control electronics for high-temperature operation[J]. IEEE Transactions on Industrial Electronics, 2015, 62(5): 3182–3191.
DOI:10.1109/TIE.2014.2379212
|
| [6] |
ZHONG Xueqian, WU Xinke, ZHOU Weicheng, et al.
An all-SiC high-frequency boost DC-DC converter operating at 320℃ junction temperature[J]. IEEE Transactions on Power Electronics, 2014, 29(10): 5091–5096.
DOI:10.1109/TPEL.2014.2311800
|
| [7] |
CHEN Zheng, YAO Yiying, BOROYEVICH D, et al.
A 1200-V, 60-A SiC MOSFET multichip phase-leg module for high-temperature, high-frequency applications[J]. IEEE Transactions on Power Electronics, 2014, 29(5): 2307–2320.
DOI:10.1109/TPEL.2013.2283245
|
| [8] |
NAKAKOHARA Y, OTAKE H, EVANS T M, et al.
Three-phase LLC series resonant DC/DC converter using SiC MOSFETs to realize high-voltage and high-frequency operation[J]. IEEE Transactions on Industrial Electronics, 2016, 63(4): 2103–2110.
|
| [9] |
SAFARI S, CASTELLAZZI A, WHEELER P. Comparative performance evaluation of SiC power devices for high temperature and high frequency matrix converter[C]//Energy Conversion Congress and Exposition. Denver, Colorado, USA: IEEE, 2013: 956-962. |
| [10] |
HE Jiangbiao, ZHAO Tiefu, JING Xin, et al. Application of wide bandgap devices in renewable energy systems-Benefits and challenges[C]//International Conference on Renewable Energy Research and Application. Hangzhou, China: IEEE, 2014: 749-754. |
| [11] |
PREZ-TOMS A, BROSSELARD P, GODIGNON P, et al.
Field-effect mobility temperature modeling of 4H-SiC metal-oxide-semiconductor transistors[J]. Journal of Applied Physics, 2006, 100(11): 1–6.
|
| [12] |
FAYYAZ A, YANG L, CASTELLAZZI A. Transient robustness testing of silicon carbide (SiC) power MOSFETs[C]//European Conference on Power Electronics and Applications (EPE). Lille, France: IEEE, 2013: 1-10. |
| [13] |
OTHMAN LEFEBVRE S, BERKANI M. Investigation of 1. 2 kV investigation of SiC MOSFETs for aeronautics applications[C]//European Conference on Power Electronics and Applications (EPE). Lille, France: IEEE, 2013: 1-9. |
| [14] |
CASTELLAZZI A, FUNAKI T, KIMOTO T, et al. Short-circuit tests on SiC power MOSFETs[C]//International Conference on Power Electronics and Drive Systems (PEDS). Kitakyushu, Japan: IEEE, 2013: 1297-1300. |
 2018, Vol. 50
2018, Vol. 50


